文 | 煜捷史馆
编辑 | 煜捷史馆
-<复合材料与横向声子传输>-
近年来,由于人工智能(AI)和物联网(IoT)数据通信的进步,智能社会的发展导致了对半导体设备的更大需求。
随着半导体设备集成度的提高,设备驱动等半导体操作中所涉及的热预算也在增加,这导致了各种与性能下降、器件破坏和集成度限制有关的问题。
为了提高半导体器件的性能,人们设计了一种金属氧化物半导体场效应晶体管(MOSFET),使其小型化,将结构从平面改为翅片和纳米片,并考虑了锗等材料。
在MOSFET中,有三个原因导致电子迁移率降低: 库仑、粗糙度和声子。
接下来,煜捷将为你讲述Si NP/SiGe复合材料层在横向声子传输中,是如何消减晶体管区域热量的。

当10纳米以下的高级互补-MOS(CMOS)降低载流子迁移率时,声子的电子散射(电子-声子散射)尤其参与其中。
由于焦耳热,电子通过沟道区以及在沟道和漏极的接口处会产生热量。
MOSFET沟道区的过多热量导致电子-声子散射,从而限制了最大电子迁移率。
已经报道了电导率和热导率的积累作为纳米结构尺寸的函数,涉及到硅的平均自由路径(MFP)的趋势。
电子的MFP大约小于20纳米,而声子积累的MFP需要超过几百纳米。
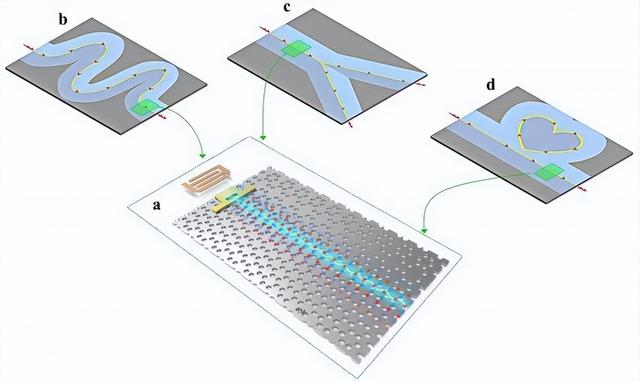
在大小为20到几百纳米的区域,声子被充分散射,因此电子可以在没有散射的情况下被转移。
一个控制在这种尺寸区域内的纳米结构可以在保持电子迁移率的情况下减少热传导。
在我们以前的工作中,我们通过使用带有自旋玻璃或硅锗的硅纳米柱(NP)作为热电设备,实现了低热导率和高电导率。
此外,预测了一个排列整齐且非常微小的周期性结构,超过5个周期的结构将特定频率的声子定位为一个声子晶体。
因此,我们提出使用一个MOSFET结构,其特点是以排列整齐的Si NP/SiGe层间复合膜作为通道区域。

电子可以在没有任何散射的情况下将通道区域转移到NP结构的侧面方向,然后声子被NP界面充分散射。
电子-声子散射在通道区的热环境下发生,基于温度的函数。通道加热源的主流是将焦耳热从漏极区输送到通道区。
因此,沟道区有序的Si NP的良好声子散射结构的作用是防止来自漏极的热量渗透和由于不干扰电子运输而产生的潜在热量。
因此,这种结构能够消除声子-电子散射,实现更高的电子迁移率,并减少MOSFET的发热。

因此,一个具有SiGe嵌入的排列整齐的Si NP结构将通过提高电子迁移率和控制声子传输散射来提供一个高性能的MOSFET。
在这项研究中,为了管理通道区域的声子传输,我们制造了具有不同NP间隙的排列整齐的Si NP/Si0.7Ge0.3,以研究热传导横向方向的声子传输。
然后我们使用3-omega方法和模拟进行了测量。

-<实验设置>-
下图是我们的中性束蚀刻(NBE)系统的示意图。
该系统由电感耦合等离子体(ICP)源和一个碳孔板组成,在这里可以防止紫外线(UV)光子的照射,高能离子可以通过碳孔板从等离子体有效地转化为中性光束。
由于消除了带电粒子和紫外线辐射对基材的入射,NBE可以实现超精确的纳米蚀刻,并完美地抑制了加工表面缺陷的形成。

Si NP结构是在绝缘体上的硅(SOI)晶圆上制造的。SOI晶圆由100纳米厚的硅层和140纳米厚的二氧化硅层组成,位于725纳米厚的硅(100)衬底上。
首先,用1%的HF溶液去除Si衬底上的原生SiO2膜2分钟,然后,通过中性束氧化工艺合成受控的SiO2薄膜(3.2nm厚)[15]。
第二,用旋涂法排列铁蛋白分子[16]。铁蛋白之间的距离由不同分子量的装饰聚乙二醇(PEG)来调整[17]。
具体来说,2k、10k和20k(k=1000)的PEG分子量分别为铁蛋白间距(铁蛋白的中心到中心的距离)的25、40和60nm。

第三,在氧气环境下,将涂层的铁蛋白在400℃下进行退火,以去除表面的蛋白质外壳。之后,只有铁芯留在了SiO2薄膜的表面上。
然后在NF3气氛下通过H2自由基处理和退火除去铁芯之间的SiO2层。
NP结构是通过氯气NB蚀刻25分钟制造出来的。之后,用盐酸溶液去除NP顶端剩余的氧化铁芯。
最后,用低压化学气相沉积(LPCVD)的方法将SiNP嵌入Si0.7Ge0.3。

各向异性的热导率是用3-omega方法进行的,Al线为加热器,Al垫连接到电压源和锁相放大器。随着铝加热器宽度的改变,热量在横向的分布也发生了变化。
在沉积的50纳米厚度的Al2O3层上准备了宽度为5至50微米、厚度为50纳米的铝线。平台温度为300K,样品室的压力为10-3Pa。
等待获得的数值足够稳定后,对获得的50次数值进行平均。请注意,热导率的横向方向对于考虑通过MOSFETs通道区域的电子-声子散射更为重要。
因此,利用3-omega方法来测量铝加热器不同线宽的热导率,适合于估计热导率的横向或纵向方向。

通过Landauer方法模拟了体部和横向的热导率。我们参照SEM图像中实际的Si NP平均高度和间距对Si NP结构进行建模。
其他参数(有效质量、带隙、弹性常数等)与其他地方报道的一样。对于横向方向,我们利用了顶视NP模型的周期性边界条件。
模拟模型在我们的Si NP排列中使用了一个理想的结构。在这项研究中,Si NP结构被制作成30毫米见方的大面积。
对于模拟,如果模拟模型与真实结构一起设置,NP密度超过1010∼1011 /cm2。因此,通过在宏观尺度上设置周期性的Si NP结构来模拟热导率的横向方向。对于垂直方向,使用9×9的对称矩阵,如图(c)所示。

-<结果和讨论>-
下图显示了以(a)PEG2k、(b)PEG10k和(c)PEG20k铁蛋白分子为蚀刻掩膜的Si NP结构的鸟瞰SEM图像以及NP中心到中心的间隙分布。
Si NP的高度为90纳米,(a)、(b)和(c)的直径分别为12、13和13纳米。

如表格所示,从PEG2k到PEG20k的NP密度随着PEG分子量的增加而降低。
表格显示了Si NP分布的直径、平均值、标准偏差和密度。
图(a)-(c)中从边缘到边缘的NP间隙分别为13、27和47纳米。
此后,我们把这些样品称为12/13、13/27和13/47纳米,数字是指NP直径/间隙。NP的距离被控制在20%以内。

由Si0.7Ge0.3嵌入的Si NP的横截面SEM图像。Si NP/Si0.7Ge0.3复合膜的厚度为100纳米。Si0.7Ge0.3完全沉积在Si NP结构中。

上图显示了所有Si NP/Si0.7Ge0.3复合膜样品在(a)垂直方向和(b)横向方向上的热导率及误差条,由3-omega方法测量,以及各向异性热导率的模拟结果。
对于垂直方向,当间隙从13纳米增加到47纳米时,热导率从2.1 W/m/K轻微增加到2.8 W/m/K。

热导率的降低是由于界面散射效应造成的。至于尺寸效应,我们发现声子对垂直方向的MPF与复合膜高度相同,为100nm。
在这个条件下,先前的研究表明,这应该减少到30%∼50 W/m/K的热导率,由于Si和Ge之间的体积比,但我们的结果表明,热导率的减少是体积比的10倍以上。
此外,所有的NP样品都表现出各向异性的热导率特性。横向的热导率比垂直方向的热导率减少了25%。
如前所述,由于声子积累的MPF较长,横向的声子传输可以被NPs之间的界面充分散开。
因此,在Si NP结构的情况下,热导率急剧下降。

此外,由于Si0.7Ge0.3的体积随着NP密度的降低而增加,热导率可以通过增加NP的间隙来控制。
对于上述的模拟结果,我们从散装材料的MFP和另一个内部散射过程的特征长度来估计热导率,与实验结果相比,所有热导率结果的趋势都非常一致。
对于12/13样品的横向方向,实验结果比模拟结果大84%。这是因为Si NP分布的扩散。
在这个模拟中,NP排列是具有周期性结构的方形网格,而我们的NP排列包括方形网格、三角形网格,以及由于自组装PEG-铁蛋白排列而产生的随机排列。

众所周知,NP网格的不同导致了不同的热通量。
因此,我们不仅要关注铁蛋白的密度,还要关注铁蛋白的分布。12/13号样品的平均分布和标准偏差为25纳米,5纳米(表1),分布为18.5%。
13/27、13/47样品的分布为18.9、20.0%,所有样品的误差都在1.5%以内。
因此,在狭窄的NP间隙区域,NP分布对热导率的影响比在宽阔区域更强烈。
因此,我们得出结论,低热积聚,即声子的稀疏状态密度(DOS),使得由于MPF的声子积聚而产生的散射变得容易。

硅体和Si0.7Ge0.3体的热导率分别为140和4W/m/K。横向的声子传输被NPs之间的界面适当地散射了。因此,热导率急剧下降。
此外,我们发现,热导率可以通过增加NP的间隙来控制,因为随着NP密度的降低,Si0.7Ge0.3的体积也在增加。
12/13、13/27和13/47样品的情况是,虽然Si0.7Ge0.3体积为2.9%,但分别为Si体积的0.4%、0.6%和1.0%。
因此,与硅块相比,横向的声子传输从1/250急剧地消除到1/100。

先前的一项研究报告说,在极低温度(4K)下工作的CMOS晶体管的迁移率比室温下的操作高几十倍。
这可能是因为在通道区域的发热减少,消除了电子-声子散射。
我们期望Si NP/Si0.7Ge0.3复合结构也能因极低的热导率而大大减少电子-声子散射,这与Cryo-CMOS的操作相似。
Cryo-CMOS需要冷却功能来实现通道区域的无视热效应。Si NP/Si0.7Ge0.3复合结构提供了控制和限制来自漏极的声子传输和在通道区域的生成。
这表明电子可以在沟道区移动,在结构上和能量上都不会受到任何干扰。

-<结论>-
我们通过改变NP的间隙从13到47纳米,制造了一个排列整齐的Si NP/Si0.7Ge0.3层间复合膜。
通过3-omega方法和Lander方法研究了热管理的Si NP/Si0.7Ge0.3层间复合结构通过热导率的声子传输行为。
结果显示,由于控制了侧向的声子传输,我们的Si NP/Si0.7Ge0.3层间复合膜的热导率比Si体低1/100倍。
此外,狭窄的NP间隙导致了有效的声子散射,这是由于低热积聚,即声子带的DOS密度低。

热导率测量和模拟的结果表明,NP结构可以通过改变NP间隙来调节声子在横向的传输。
Si NP/Si0.7Ge0.3复合结构实现了控制和限制声子从漏极的传输和在沟道区域的产生。
因此,这种结构实现了在平面型MOSFET的同一电子传输方向上管理声子传输的第一步,并代表了先进CMOS器件热损伤的一个有希望的解决方案。

