前 言 .........................................................4
1 范围.........................................................6
1.1 范围 ........................... ......................6
1.2 简介 .............................. ......................6
1.3 关键词 ........................... .......................6
2 规范性引用文件...............................................6
3 术语和定义...................................................6
4 文件优先顺序.................................................7
5 材料要求.....................................................7
5.1 板材 ................................ ....................7
5.2 铜箔 ................................ ....................7
5.3 金属镀层 .................................................8
6 尺寸要求.....................................................8
6.1 板材厚度要求及公差 ........................................8
6.1.1 芯层厚度要求及公差 .................. ...................8
6.1.2 积层厚度要求及公差 ................. ....................8
6.2 导线公差 ..................................................8
6.3 孔径公差 ..................................................8
6.4 微孔孔位 ..................................................9
7 结构完整性要求..............................................9
7.1 镀层完整性 ................................................9
7.2 介质完整性 ................................................97.3 微孔形貌 ..................................................97.4 积层被蚀厚度要求 ........................................107.5 埋孔塞孔要求 ............................................108 其他测试要求................................................108.1 附着力测试 ............................. ................109 电气性能....................................................119.1 电路 ...................................................119.2 介质耐电压 ...............................................1110 环境要求...................................................1110.1 湿热和绝缘电阻试验......................................1110.2 热冲击(Thermal shock)试验.............................1111 特殊要求...................................................1112 重要说明................................................11


RCC:Resin Coated Copper,背胶铜箔。
LDP:Laser Drillable Prepreg,激光成孔半固化片。
Build-up Layer:积层,如图3-1,叠积于芯层表面的高密互联层,通常采用微孔技术。
Microvia:微孔,孔直径≤0.15mm的盲孔或埋孔。
Target Pad:如图3-1,微孔底部对应Pad。
Capture Pad:如图3-1,微孔顶部对应Pad。
Buried Hole:埋孔,如图3-1,没有延伸到PCB表面的导通孔。
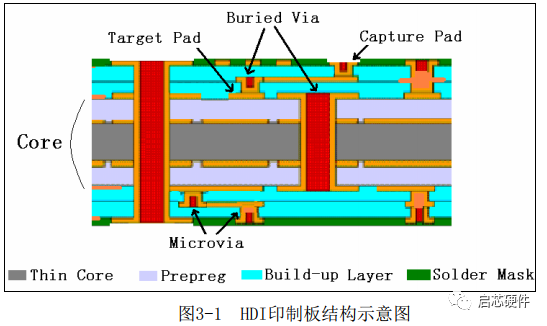
导线和过孔的要求


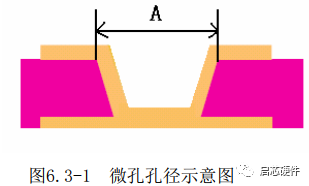
6.4 微孔孔位
微孔允许与Target Pad及Capture Pad相切,但不允许破盘。

7、结构完整性要求

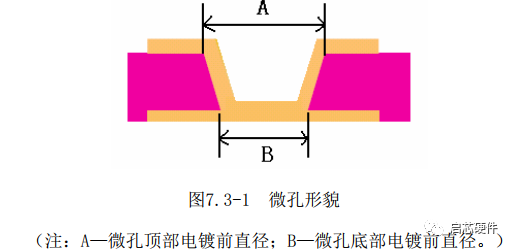

7.4 积层被蚀厚度要求
若采用Large Windows方式,积层介质在工艺过程中(如Desmear)被蚀厚度H≤10um。
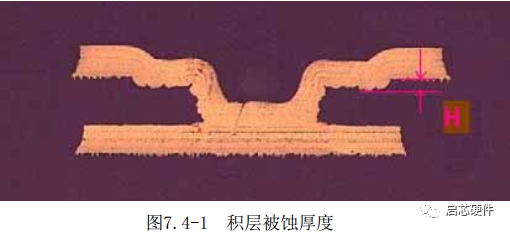
9 电气性能
9.1 电路
绝缘性:线间绝缘电阻大于10MΩ;测试用的网络电压要能提供足够的电流,但不能引起网络
间飞弧;最小测试电压≥40V。
9.2 介质耐电压
依照IPC-TM-650-2.5.7进行测试,要求耐压1000VDC,且在导体间没有闪光、火花或击穿。
文档下载链接:
链接:https://pan.baidu.com/s/1O9UulfyCSDcNb7SOUi7lwQ?pwd=qxcc
提取码:qxcc

