引言
在现代战争和未来战争中,目标检测和制导是一个非常重要的技术指标,而目标检测和制导的好坏将直接关系到目标检测和制导的好坏。
日益变化的作战环境对雷达提出了更高的探测距离、更高的探测精度和更强的抗干扰能力的需求。具体表现在雷达技术参数上,就是需要雷达拥有更大的探测功率、更小的尺寸和更高的集成度。
检测功率越大,雷达的热流越高,其冷却速度也就越快,而尺寸越小,则需要更高的集成度和更少的尺寸,以满足更多的应用需求。
 一、基于 Si基的多层式有源芯片的多层式结构
一、基于 Si基的多层式有源芯片的多层式结构Si基多层型有源天线阵列在空间和散热等方面都有一定的限制,要求其具有较高的综合性能。设计首先要按照射频链路的要求,对无线通信和接收的系统进行了详细的规划,并对其进行了 EMC的测试。
依据其空间特性,进行线路布置,并结合其热分配模拟架构,对需进一步优化提升的区域,添加对应的散热架构,最终实现高密度、高精度的多层微波集成电路。

该有源子阵RF链路的组成是:收发链路,电源调制,幅度-相位网络,其中收发链路是一个功率分布的体系,4个 RF接收信道组成。
电源调制器将8 V和5 V电源分别转化为功率放大器所需的8 V脉冲信号、低噪声放大器和驱动放大器所需的5 V脉冲信号,从而实现对功率放大器和低噪声放大器等的脉冲电源调制,从而让其在指定的重复频率下工作。
该幅相电路以数字移相器和相应的串联和驱动器为主体。RF信道的设计原理方块。各信道采用单独的电源晶片及 LNA,晶片由发射/接收转换器与天线共用埠相连,以确保输出之高品质及降低噪音。

多功能晶片实现了发送与接收的移相,衰减,集成了发送与接收转换器,发送与接收补偿放大器。射频信道,部分功率调制和电容等外围器件被整合到了硅片上。
通过测量,可以达到接收增益超过20 dB,发送增益超过20 dB的目标,单通道接收支路噪声系数为3.2 dB。
按照芯片的作用,将 RF芯片与低频电源及控制芯片,分成两组4个硅衬底的包封。利用倒装式植球式结构将两片硅片联结在一起,实现了射频、控制和电源的一体化。
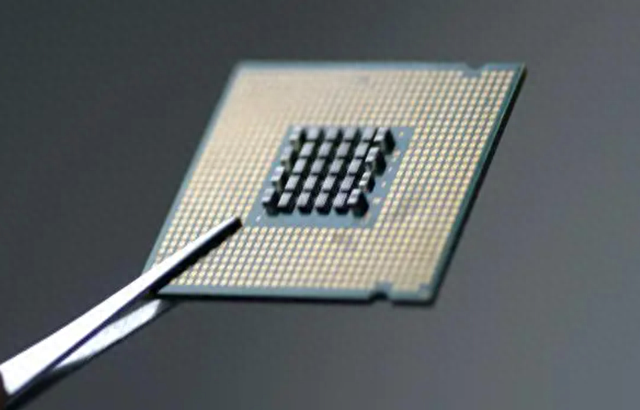
在下部四层射频硅基板封装中,将硅基、砷化镓基和氮化镓基三类芯片集合起来,展开纵向立体互联,从而可以达到微波多层集成的目的。在底部硅基板中,增加了微流道的设计,可以让高功率末级功放产生的热量能够被快速地传导出去,从而提升了功放工作的稳定性。
在上层四层低频硅基板封装中,将电源调制,低频控制类芯片、外围电容电阻等器件进行了组合。

(TSV 基板叠层布局示意图)
二、一种基于嵌入式矩形波导管的新型 Silicon RF适配器技术一种全新的集成了长方形波导的硅基射频适配片,利用长方形波导的小口径、大长径比的长方形波导通孔,在 RF适配片上形成纵向贯通长方形波导通孔的长方形波导通孔,以解决现有 RF适配片中因损失机理的复杂性而导致的设计和工艺研发困难。
波导透射信道是一种常用的透射构造。然而,传统的光波传导结构是由一种具有空心的金属材料制成的。由于硅衬底材质的限制,常规的光传播方式无法被利用。

此外,本项目还将利用小口径、大纵深比的 TSV阵列模仿波导的金属壁面,构建出一种新型的 Si基光波导传输结构,以达到微型化、高密度的目的。
其左侧和右侧分别为波导的 RF发射口,两侧各有一列 TSV阵列构成波导的一条狭窄的金属线。该硅衬底的上、下两个面都被一种金属所覆盖,用作该光波导管的一个宽侧的金属壁。
波导是一种具有与高通滤波相似的带宽传播方式,具有较好的传播性能,能够传播比截止频率更高的带宽的电磁波。
从体积角度来看,必须在波导中选择合适的波导,以保证其在工作频段内能很好地传播,同时还要保证其小型化。

(基于小孔径高深宽比 TSV 矩形波导传输通道基本结构)
由模拟结果可见,在35 GHz以下,基于硅的波导传送结构均能获得很好的微波信号传送,且回波损失S11均不超过-20 dB,模拟的插入损失也不超过0.1 dB。
3.2基于矩形波导片的新型硅基射频适配器的制备技术,其关键技术在于制备具有小孔直径大、深度大比阵列的 TSV孔刻蚀、晶种沉积和 TSV孔镀覆三个工序。
以 Bosch技术为基础,利用刻蚀气体SF6与C4F8在S4F8之间的相互切换,分别进行深度刻蚀与侧壁不同角度的钝化异形刻蚀,完成深度刻蚀与侧壁表面不同角度的钝化异形刻蚀,最终制备出高阻硅基双抛层超平面(400µ m)薄膜。

本项目拟以光刻工艺为基础,通过旋涂、软烘烤、曝光、显影、镜检、坚膜等一系列工序,获得具有6.8-7.2微米厚的刻蚀掩模。
利用 DRIE技术,对硅基板进行了100μ m的深度/孔径10 mm的 TSV盲孔的处理,并对其进行了初步的试验,以此为基础,对其进行了初步的刻蚀。
并对其进行了初步的试验,刻蚀速度为0.185μ m/s,耗时54秒。廓仪探测刻蚀结构的真实刻蚀深度在105微米左右,刻蚀孔径在9.48微米左右。

根据硅通量大的特点,采用原子层沉积法制备了硅通量晶体管。
原子层析法是一种采用交变脉冲方式进行表面饱和反应的新型制备技术,它以两个半循环为一个生长周期,可以获得0.02-0.1 nm的单层超细晶种材料,并且可以通过调节其数量来调控其膜厚。

(种子层沉积形貌)
以SiO2为基材、4秒的先驱植入、120摄氏度的基材、2500次的反复注射、90纳米的晶种层淀积、全表面晶种层均是连续的、致密的晶种。
电镀铜填补 TSV孔所使用的镀层液是以酸性硫酸铜、酸性铜氟硼酸、甲基硫酸铜溶液等为基本液,它可以为电镀过程提供酸性溶液环境、二价铜离子等。
在此基础上,采用二价 Cu作为电解质,以提高电解质量,提高电解质量,提高电解质量,提高电解质量。

因为存在着数量众多的 TSV孔的阴极形态的特殊性,所以在填补 TSV孔所用的铜电解溶液中,通常会添加氯离子以及具有抑制、加速、整平等效果的化学添加剂,并引入流体力学作用。
在此基础上,通过电化学协同效应,保证 Cu在 TSV孔洞中的沉积和结晶得到有效的抑制,并促进 Cu在 TSV孔洞中的高效传输和沉积和结晶,从而达到精确调控 TSV孔洞中 Cu的生长。
三、利用微流道进行辐射辐射的评价以400毫米的高阻硅超平面为上层覆盖层,以250毫米的高阻硅超平面为底层覆盖层,进行深度活性离子腐蚀。
利用刻蚀气SF6与钝化气C4F8在两个方向上的交互作用,实现对微流道的深度刻蚀与对侧壁进行不同程度的钝化刻蚀,并在上、下两个方向刻蚀出微流道,进而刻蚀出微流道的进出口。

在上、下盖板各自形成一个微流体通道之后,再通过硅-硅的晶圆对晶圆的晶圆直接结合来实现两个晶圆之间的硅基微流体通道的连接。
在键合过程中,键合精度对微流道结构有很大的影响,键合同时还需防止由于原片翘曲造成的键合失败或者裂片问题。
在焊接之前,先将焊条的表面清洗、激活,然后再用红外线定向焊接,再用高温退火;最终测试了硅-硅键合的效应。将该方案焊接成的硅基微型流体芯片见图10。

在此基础上,建立基于硅材料的热辐射微流道实验系统。在硅衬底上制备了铂线,并在其下表面制备了一层金属膜。
在 TSV适配器上,采用铝线焊接方式,把铂仿真热源扇出到 PCB上,从而使其导电。在此基础上,利用软式水泵将其由冷却剂交换器中的去离子水送入试验箱中的微型流动通道,再回到冷却剂交换器中,再将软式水泵的接口调节到流体速度。

对直流稳压电源进行调整,并对输出的电流进行测量。在此基础上,采用 K型热电偶联技术,结合红外热成像技术,实现对 TSV适配器表面温度、冷却剂(去离子水)进、出水温度的同时检测。
根据所施加的电流和电压,计算出了所需的导热系数。在附图11中显示了一个硅基冷却的微型流体通道的实际试验。在80毫升/分钟的流率下,硅衬底表面的最大温度是51摄氏度,在该情况下,与之相对应的最大热流量是419 W/cm2。
结语硅基3D集成技术是实现微型化、轻量化和高性能化的核心技术。开展基于 Si基阵列的基片加工、微流道制备和多层 Si基片叠加等技术的研究,研制出适用于各类雷达的四路 Si基阵列。

(微波有源子阵集成样机)
参考资料《微纳电子与智能制造》《微系统三维集成技术的新发展》《三维微系统封装微波特性研究》
