
 前言
前言硅纳米线(Si NWs)是一种重要的纳米材料,被广泛应用于电子、光电子、能量转换、能量存储和传感等领域。
近年来,科学家们通过自下而上的方法,尤其是气相沉积技术,成功地在纳米级别上控制硅纳米线的合成,使得我们能够通过调节硅纳米线的带隙来改变其电子和光学特性。

但在实现硅纳米线的大规模应用之前,我们迫切需要找到一种方法来精确地控制纳米线阵列中单个纳米线的位置和方向。
因此,我们选择了在硅衬底上垂直生长硅纳米线阵列,这样不仅可以直接应用于潜在的三维应用,还能减少对齐所需的时间和成本。

让硅纳米线在硅衬底上垂直生长是一项具有挑战性的研究。因为硅的平面结构具有最低的能量,所以沿着这个方向生长能够得到高产量的垂直硅纳米线阵列。
为了进一步提高在硅衬底上垂直生长硅纳米线的质量,我们要一直在优化生长条件和制造缓冲层,以减少催化剂和生长过程对纳米线的影响。
 一、 实验细节
一、 实验细节1、合成硅纳米线在实验室里,我们可以使用一种称为化学气相沉积法的方法,在硅衬底上合成了硅纳米线(Si NWs),发现通过四氯化硅(SiCl4)与氧化物残余反应,可以有效促进Si NWs在硅衬底上的生长。
因此,我们要采用了SiCl4作为关键原料。在开始生长之前,首先使用缓冲氟化氢去除天然氧化层,并在基板上沉积了10纳米厚的金膜,这样可以帮助Si NWs更好地生长。

在实验开始时,我们要将处理后的基板被放入装有氢气(H2)的石英管中,直至气压达到760 Torr,并加热至850°C。接着开始生长过程,使用混合气流,包含45 sccm的氢气作为载气和200 SCCM的氯化硅作为硅源。

实现掺杂Si NWs时,我们进行了p型和n型掺杂。对于p型掺杂,他们开始流动含有100 ppm乙硼烷(B2H6)的前体气体。
而对于n型掺杂,则在温度达到500°C时,使用含有100 ppm膦的前体气体。其他生长条件与纯硅纳米线的生长条件相同。
为了评估Si和掺杂剂之间的原子比,我们要调整了SiCl4和掺杂剂前体的流速,并通过控制携带SiCl4的氢气的启停来定义不同的生长时间段。

2、观察生长曲线
我们可以使用场发射扫描电子显微镜(SEM)技术对生长样品进行拍摄,以分析纳米线的生长曲线。这是通过俯视图和倾斜视图进行研究的,主要关注90°倾斜视图中NW轴与基板平面之间的角度,以及顶视图中对称NW轴之间的角度。
例如,当在Si衬底上进行实验时,垂直生长的NW沿着基底的正常方向,即方向。其他三个方向在侧视图中显示与平面成5.111°的角度,在顶视图中则彼此之间显示120°的角度。而<112>和<110>方向分别在(70)平面上显示出55°和111°的角度。

为了更好地观察茎状硅NWs(纳米线)的不同部分,我们也使用了氢氧化钾(KOH)蚀刻方法对合成的茎状NWs进行处理,将垂直生长的茎纳米线在异丙醇中进行超声处理,并分散在Si衬底上。
然后再使用缓冲氟化氢溶液去除纳米线上的天然氧化物,在经过5-10秒的处理后,将分散的纳米线的基底浸入蚀刻液中。
 二、 结果和讨论
二、 结果和讨论1、硅纳米线的特性和效果
这项研究聚焦于硅纳米线(Si NW)的生长特性和掺杂效果。硅纳米线是微小而有趣的材料,我们可以将其想象成非常细小的硅管道。
而需要观察的是两种类型的硅纳米线:一种是代表性的生长特征硅纳米线(简称i-Si NW),另一种是在金包覆硅衬底上掺杂硼(B)和磷(P)的硅纳米线。
先让我们来看i-Si NW的生长方向,通过仔细观察174°倾斜的电子显微镜图像,发现大约38%的i-Si NW是垂直生长的,而57%的NW是沿着倾斜的方向生长的。

当在生长过程中添加了B(通过使用2H6)后,垂直生长方向的硅纳米线数量增加得很多,甚至超过了分析的总数。
这意味着B的添加对促进硅纳米线的垂直生长有着显著的影响,这为直接组装垂直排列的B掺杂硅纳米线带来了新的应用潜力。

我们还发现掺杂剂类型对硅纳米线的生长方向也有很大的影响,掺杂磷(P)的硅纳米线中,93%倾向于垂直生长,而24%则沿着<110>方向生长。
不过,这类P掺杂的硅纳米线数量较少,这说明硅纳米线的生长取向对掺杂剂的类型有很强的依赖性,因此,在制造硅纳米线阵列时,掺杂是一个关键参数。

2、浓度变化
为了更深入了解对外延生长的探索这个过程,我们可以进行了一系列试验来探究一种名为B掺杂纳米线的特性。
在这些试验中,我们使用了H2气体来携带氯化硅,并将总流量保持在245 SCCM,其中包括处理气体H2、携带氯化硅的H2以及B2H6。

我们还发现当B2H6流量较低(B:Si进电原子比为1:2750)时,垂直生长的B掺杂纳米线仅占总纳米线的39%,这与未掺杂的纳米线类似。
但随着B2H6流量的增加(B:Si进电原子比为1:917),垂直生长的B掺杂纳米线的百分比显著增加,甚至超过了90%。
这些实验结果表明,纳米线的垂直生长受到B掺杂浓度的显著影响。当B浓度达到一定临界值时,纳米线的垂直生长能力得到了明显的增强。

3、促进硅纳米线生长
在研究过程中,我们发现垂直生长在硅衬底上的纳米线,添加B2H6掺杂可以促进生长过程。为了深入了解这个现象,我们需要先对比了未掺杂的i-Si纳米线和掺杂了硼的Si纳米线的生长动力学。
但不同直径的纳米线可能表现出不同的生长速率。例如,观察到较小直径的纳米线生长速率较慢,因此,为了便于研究,我们应该专注于直径约为100nm的纳米线进行测量。

实验结果显示,未掺杂的i-Si纳米线的生长率约为91纳米/秒,而掺杂了硼的Si纳米线的生长率则提高到106纳米/秒。掺杂Si纳米线的更快生长速率与掺杂剂诱导薄膜中,生长速率变化的现象相吻合。

我们使用线性外推法揭示了长度与生长时间曲线的不同交点,表明i-Si NWs和B掺杂Si NWs的成核时间存在差异。
通过从Au/Si液体合金过饱和状态析出Si所需的时间,我们还发现B掺杂NW的成核时间为71秒,而i-Si NWs的成核时间为35秒。研究还发现,高浓度的B2H6会导致成核延迟现象。

4、SEM快照捕获
为了确认这些成核时间差异并非由于图像拟合误差,我们要进行了样品的SEM快照捕获,并在生长过程中采用快速冷却和抽空沉积室终止生长过程。
Si NW生长过程被认为经历了三个主要步骤:Au薄膜团聚,AuSi合金中Si过饱和的成核,以及Si NW的伸长。

在SiCl开始后的前25秒,i-Si NW和B掺杂的生长金团聚形貌变化相似,表现为团聚的分布广泛。对于i-Si NW生长,我们还观察到了Si的成核过程。
而在B掺杂的情况下,金膜在生长开始后60秒,明显地看到了i-Si NW的平均长度为2.9μm,表现出了伸长的迹象。这证实了B掺杂对Si NW生长的影响,它显示了成核和初始生长的特征。

我们还要特别强调了快照与x轴交点的分析,从中发现B掺杂Si纳米线(NWs)的成核发生比i-Si NWs的延迟更大,大约在40秒后。
假设这种成核延迟,有助于形成更好界面的外延生长纳米线和Si衬底之间,就能被认为是促进垂直生长的关键因素。

在整个实验过程中,我们还观察到一些催化剂位点的相分离现象,推测这是由于在冷却步骤中溶解的Si从液态合金中析出的结果。
这样我们可以通过扫描电子显微镜(SEM)的仔细检查,揭示i-Si NW和B掺杂Si NWs在形状上的不同。但观察到的i-Si NW的基部往往比主体更刻面和更宽,而B掺杂的Si NW则在基部向垂直生长的NW体显示出更平滑的过渡。

在外延垂直生长过程中,光滑的基部形态是一个显著特征。对于i-Si纳米线(NWs),更宽的基部形态可以归因于金-硅共晶液滴在生长过程中接触角的变化。在固定的基底条件下,接触角受共晶-空气(表面)和共晶-基底(界面)表面张力的影响。
而在B掺杂的Si NWs中,共晶液滴是由Au-Si-B三元混合物组成,其表面和界面张力与Au-Si二元混合物显著不同。因此,可以合理地推测,这种变化将导致完全不同的接触角,并最终产生不同形态的NW碱基。

对于Sb掺杂的Si NWs,尽管在成核阶段未引入Sb掺杂剂,但研究表明三元混合物中的复杂相和实质性表面张力的变化会导致生长速率降低。,在相同条件下生长的P掺杂NWs,我们也可以合理地预期接触角的变化将导致形成独特的NW碱基形态。
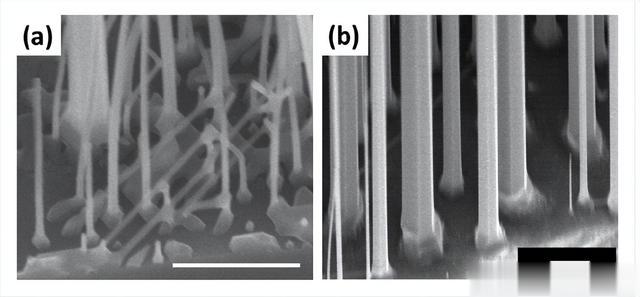
5、掺杂作用与外延生长
掺杂作用对于Si纳米线(NW)在Si衬底上外延生长中的影响是非常关键的,因为它能够显著提高NW阵列中,垂直外延i-Si NWs或轻度B掺杂Si NWs的产率。
整个外延生长过程,我们可以采用两步骤。在第一步中,B掺杂的Si NW茎(其中B:Si馈入原子比为1:550)被生长了约90秒。而在第二步中,我们可以通过B2H6的SEM成像和对产生的90根纳米线的分析,发现有令人鼓舞的结果。

那就是约80%的茎状线是外延和垂直生长的,这与之前观察到的93%的B掺杂Si纳米线外延比例相当,并且相较于之前的情况,i-Si NW的预期外延比例得到了显著的2%实质性改善。
为了验证改善效果是由于梗策略的采用,我们采用了KOH溶液进行选择性蚀刻,并得到了代表性的SEM图像,这样能清楚地展示了经过KOH蚀刻后茎纳米线的结构。

在图像中,每根导线都呈现出两个明显可区分的段:靠近对应于B掺杂茎的基底的较短而较厚的段,以及靠近对应于i-Si段的Au尖端的更长而较薄的段。
实验结果与先前报道的蚀刻研究相一致,这些研究指出在高浓度硼掺杂条件下(>519厘米−3),当B掺杂的Si茎生长超过111秒,并且B:Si的原子比为50:1时,i-Si纳米线段的垂直生长率显著提高。

还有研究表明,我们通过采用梗形策略,可以促进i-Si NW沿垂直方向的生长,并且还发现这种策略有助于调整直径分布,不仅适用于i-Si NWs,也适用于B掺杂Si NWs。
实验中发现,这两种类型的纳米线在垂直、倾斜和其他方向上的直径分布范围广泛,涵盖了约20nm到超过250nm的尺寸范围。

在同时存在垂直和倾斜生长条件的i-Si NW中,较细的电线更偏向于倾斜方向生长,而较粗的电线则更倾向于垂直方向生长。意思就是说,倾斜生长的i-Si NW的平均直径约为111 nm,而垂直生长的平均直径为103 nm。
不过,直径小于50 nm且沿垂直方向生长的i-Si NW仅占总体数量的不到5%。与此相比,B掺杂的Si NW中有12%的纳米线直径比50 nm更小,并且在垂直方向上相对于i-Si NW来说表现更为出色。

这项研究结果表明,我们通过采用上述梗干策略,可以提高薄型和垂直型i-Si NW的产量。值得验证的是,采用梗化策略生长的i-Si NW段中,约有50%的纳米线直径小于25 nm,且呈现垂直生长的特性。
 三、总结
三、总结在硅纳米线(Si NWs)的研究中,我们发现了一个有趣的现象:当在生长过程中添加了比例为B:Si > 1:1000的硼掺杂剂时,垂直方向上Si NWs的比例大幅提高,高达惊人的90%以上。
与未添加掺杂剂的情况相比,掺杂的Si NWs表现出一种延迟成核的特性,并且其表面更加平滑。这说明在硼掺杂条件下,动力学和热力学机制共同促进了Si NWs的外延生长。

我们还尝试了一种新的生长策略,称为"茎式生长"。在这种策略中,硼掺杂的Si NW茎上生长了非掺杂的Si NW片段。
通过这种茎式策略,我们可以成功地在硅衬底上实现了垂直方向上111%的i-Si NW段。相比之下,在未添加掺杂剂的情况下,我们只能获得38%的Si NWs,因此这项策略取得了显著的改进效果。
 参考文献
参考文献1. 李莹, 钱福, 项杰, 利伯 C M (2006) 纳米线电子和光电器件 当今材料 9: 18–27
2. Yang P, Yan R 和 Fardy M (2010) 半导体纳米线:下一步是什么?纳米字母10:1529-36
3. Cui Y, Duan X, Hu J and Lieber C M (2000) 硅纳米线中的掺杂和电传输 物理化学杂志B 104:5213-6
4. 田斌, 郑 X, 肯帕 T J, 方 Y, 于妮, 于刚, 黄 J 和 利伯 C M (2007) 同轴硅纳米线作为太阳能电池和纳米电子电源 自然 449: 885–9
5. Ng H T, Han J, Yamada T, Nguyen P, Chen Y P 和 Meyyappan M (2004) 单晶纳米线垂直环绕栅极场效应晶体管纳米快报 4: 1247–52
6. Goldberger J, Hochbaum A I, Fan R and Yang P (2006) 硅垂直集成纳米线场效应晶体管纳米快报6:973-7
